Others 플라즈마 세정 장비 (CCP구조)에서 자재 로딩 수에 따른 플라즈마 효과 및 Discolor
2022.03.03 13:27
안녕하세요.
플라즈마 클리닝 설비를 다루고 있는 엔지니어입니다.
설비 평가중 궁금한점이 있어서 문의하고자 글을 쓰게 되었습니다.
현재 저희 설비는 CCP 구조의 다이렉트 쳄버로 RF Generator와 Matcher를 사용하는
플라즈마 세정 설비입니다.
금번 평가시 사용하였던 자재는 Cu Layer가 노출되어있는 PCB 자재이고 챔버내 Rail이 3개로
Full Loading시 3개가 로딩되는 형식입니다. 그리고 가스는 Ar 10sccm에 파워 425W, 시간 100sec를 쓰고 있습니다.
여기서 문제가 되고 있는 점이, 자재 3개 (Full Loading) 로딩시에는 문제가 없는데
1ea개만 로딩하였을때 Rail 위치 상관없이 Cu Layer에서 Discolor (Cu층이 어둡게 변함)가 나오고 있습니다.
저희 판단으로 Cu가 산화 반응을 일으킨 것으로 보고 있습니다.
이렇게 자재 로딩 수에 따라 Discolor가 나오기도 하고 안나오기도 하는점이 이해가 안되고
플라즈마 이론적으로 어떻게 해석해야 하는지 몰라 문의드리고 싶습니다.
저희가 생각하기에는
첫번째, 같은 쳄버내 체적, 같은 가스량으로, 플라즈마 이온들이 아무래도 3개의 자재의
분산되다 보니 자재당 플라즈마 효과는 떨어지고 그래서 Discolor도 적어진다고 생각하고,
두번째, Full Loading시 1개 로딩보다 상대적으로 전자 축적이 분산되어 약한 음전위(Self Bias)가 걸리게 되어
플라즈마 효과가 감소되고 Discolor도 감소하게 되지 않나 생각하고 있습니다.
플라즈마 전문가분들께 꼭 답변을 들어 원인을 알아내 해결을 하고 싶습니다.
부디, 플라즈마에 대한 넓은 식견과 해안으로 도와주시면 감사하겠습니다.
※ 저희 설비 CCP구조 도식 및 실제 쳄버사진도 참고용으로 첨부하였습니다. (사진내 자재는 금번 질문과는 상관이 없습니다.)
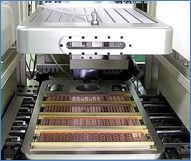
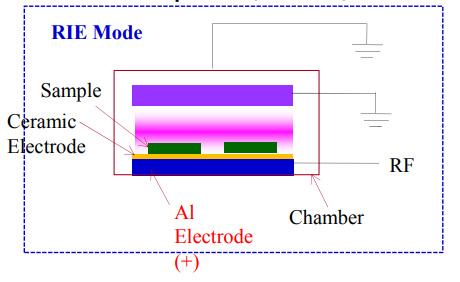
답변부탁드립니다.
감사합니다.
| 번호 | 제목 | 조회 수 |
|---|---|---|
| 공지 | [필독] QnA 글 작성을 위한 권한 안내 [267] | 76710 |
| 공지 | Q&A 검색 길잡이 – 내게 필요한 정보를 더 빠르게 찾는 방법 | 20163 |
| 공지 | 개인정보 노출 주의 부탁드립니다. | 57163 |
| 공지 | kr 입자 조사에 의한 Cu 스퍼터링 에너지 및 이탈 속도 분포 함수 | 68685 |
| 공지 | 질문하실 때 실명을 사용하여주세요. [3] | 92246 |
| 728 | ICP dry etch 장비에서 skin depth가 클수록 좋다고 볼 수 있는 건가요? [1] | 24328 |
| 727 | [질문] ICP plasma 를 이용하여 증착에 사용하고 있는데요. [3] | 24305 |
| 726 | Dechucking 시 wafer 상의 전하 문제 | 24172 |
| 725 | 플라즈마에 관해 질문 있습니다!! | 24121 |
| 724 | self Bias voltage | 24030 |
| 723 | plasma and sheath, 플라즈마 크기 | 23973 |
| 722 | 플라즈마 쉬스 | 23934 |
| 721 | Arcing | 23799 |
| 720 | N2 플라즈마 공정 시간에 따른 Etching rate의 변화 이유가 알고 싶어요 [2] | 23758 |
| 719 | 플라즈마 물리학책을 읽고 싶습니다. | 23437 |
| 718 | 광플라즈마(Photoplasma)라는 것이 있는가요? | 23381 |
| 717 | HVDC Current '0'으로 떨어지고, RF Bias Reflect (RF matching이 깨지는 현상) 발생 | 23332 |
| 716 | CCP 방식에 Vdc 모니터링 궁금점. | 23260 |
| 715 | DC glow discharge | 23245 |
| 714 | 고온플라즈마와 저온플라즈마 | 23124 |
| 713 | No. of antenna coil turns for ICP | 23094 |
| 712 | 입력전력에 따른 플라즈마 밀도 변화 (ICP/CCP) | 23058 |
| 711 | CCP/ICP , E/H mode | 22974 |
| 710 | 안녕하세요. O2 Plasma 관련 질문좀 드리겠습니다. | 22940 |
| 709 | floating substrate 에서 sheath 형성 과정 의문점 [2] | 22851 |

해당 문제는 장비를 직접보고, 장비를 설계하신 분과 같이 문제를 풀어 보시기를 추천드립니다.
일반적으로 CCP는 전극간에 형성된 RF 전기장으로 플라즈마를 만드는 특징을 가집니다. 이름하여 capacitively coupled plasma 라 하니, 상대 전극의 재질 및 구조에 따라서 공간 전기장은 바뀌고 결국 그 공간에서 만들어지는 플라즈마의 속성은 다르게 되는 특징이 있습니다. 특히 전극간, 즉 전극면에 수직으로 형성되는 전기장에 플라즈마 구속이 일어나기 쉽습니다. 그렇다고 전기장에 완전히 구속되지는 않고 전극 사이 바깥쪽 방향으로 플라즈마는 확산되게 됩니다.
제가 생각하는 불균일 원인은 전극면에 놓인 재료의 전기적 성질이 다른 원인이 가장 큽니다. 따라서 1매를 처리하는, 현재와 같은 경우에는 dummy load를 좌우에 뭍혀서 같이 처리하는 방법을 자주 사용하곤 합니다. 3매를 처리할때와 같은 조건을 이용하는 것입니다. 다만 dummy glass 가 오래 사용하다보면 particle 이나 불순물 소스가 되니 표면 상태를 보고 주기적으로 교체 혹은 처리 후에 사용하는 방안도 권장됩니다.
서두에도 말씀드렸듯이, 전문가 초빙하시고 장비 설계 하신분 모셔서 같이 풀어야, 공정 재현성이 보장될 것 같습니다.