kr 입자 조사에 의한 Cu 스퍼터링 에너지 및 이탈 속도 분포 함수
2009.11.17 16:06
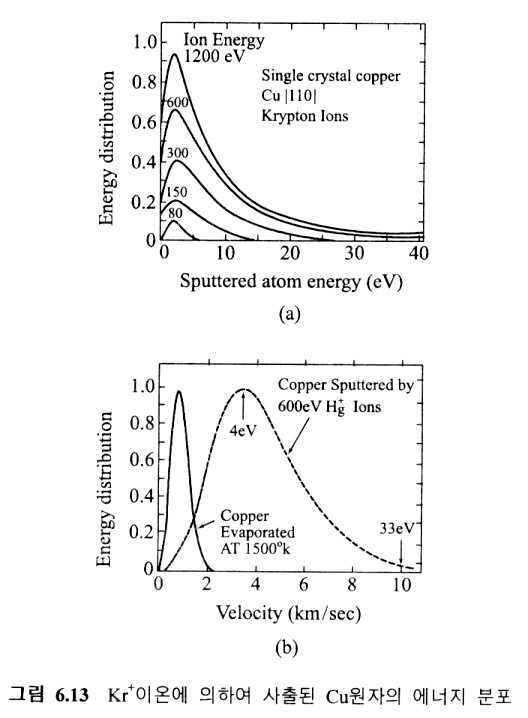
안녕하세요. 전남대학교 정세훈이라고 합니다.
몇가지 궁금한점이 있어 질문드립니다
a) the typical energy of sputtered Cu atoms if the Ar ion has an energy of 500 eV.
b) the typical energy of sputtered Cu atoms if the Ar ion has an energy of 5000 eV
Cu원자의 에너지값이 어떻게되나요? 여러논문을 검색해보았는데
thompson distribution E/(E+Eb) 에 대해서는 나오는데.. 계산이 잘 안돼서요..
--------------------
위의 질문에 대한 참고 자료를 군산대학교 주정훈교수님께서 올려 주셨습니다. 그림과 같이 Kr 입자 조사에 의한 스퍼터링된 Cu의 에너지 및 이탈 속도 함수를 보여주고 있습니다. Ar과 조사 입자의 질량 차이가 있을 뿐 이를 고려한다면 거의 현상은 유사할 것으로 판단됩니다. 이 자료는 교재에 있다고 하니 참고하시기 바랍니다.
댓글 0
| 번호 | 제목 | 조회 수 |
|---|---|---|
| 공지 | [필독] QnA 글 작성을 위한 권한 안내 [279] | 77078 |
| 공지 | Q&A 검색 길잡이 – 내게 필요한 정보를 더 빠르게 찾는 방법 | 20393 |
| 공지 | 개인정보 노출 주의 부탁드립니다. | 57301 |
| » | kr 입자 조사에 의한 Cu 스퍼터링 에너지 및 이탈 속도 분포 함수 | 68846 |
| 공지 | 질문하실 때 실명을 사용하여주세요. [3] | 92853 |
| 29 | 식각 시 나타나는 micro-trench 문제 [1] | 2035 |
| 28 | 터보펌프 에러관련 [1] | 1773 |
| 27 | DRY Etcher Alram : He Flow 관점 문의 드립니다. [1] | 2375 |
| 26 | 챔버 임피던스 변화에 따른 공정변화 [1] | 1197 |
| 25 | RIE 공정시에 형성되는 두 효과를 분리해 보고 싶습니다. [1] | 856 |
| 24 | etching에 관한 질문입니다. [1] | 2283 |
| 23 | DRAM과 NAND에칭 공정의 차이 [1] | 5500 |
| 22 | Etch공정(PE mode) Vpp 변동관련. [1] | 2353 |
| 21 | PR wafer seasoning [1] | 2707 |
| 20 | wafer 두께가 증가함에 따라 Er이 급격하게 떨어지는 현상 [1] | 1825 |
| 19 | Plasma etcher particle 원인 [1] | 3028 |
| 18 |
SiO2를 Etching 할 시 NF3 단독 보다 O2를 1:1로 섞을시 Etching이 잘되는 이유
[1] | 5968 |
| 17 | 안녕하세요 텅스텐 에치에 대해 질문드리겠습니다. | 1146 |
| 16 | ICP와 CCP의 차이 [3] | 12551 |
| 15 | RIE에 관한 질문이 있습니다. [1] | 2681 |
| 14 | Plasma Etch시 Wafer Edge 영향 [1] | 3577 |
| 13 | RPS를 이용한 NF3와 CF4 Etch Rate 차이 [4] | 6301 |
| 12 |
poly식각을 위한 조언 부탁드립니다.
| 1428 |
| 11 | SiO2 식각 위한 Remote Plasma Source관련 질문 드립니다. [1] | 5414 |
| 10 | 안녕하세요 반도체 공정 중 용어의 개념이 헷갈립니다. [1] | 17588 |
