CCP CCP 설비에서 Vdc, Vpp과 Power에 대해 문의드립니다.
2022.07.10 01:17
질문 드리기 앞서 Self Bias, Sheath Potential, Vpp, Vdc, Plasma에 대해 본게시판 및 웹 검색으로 사전 공부한 이후, 제가 개념을 적절히 이해한 게 맞는지 질문드리는 것이 목적임을 알려드립니다.
많이 부족하여 기본적인 개념에서 혼동이 오는듯 합니다. 연구원분들께서 도움 주시길 간곡히 부탁드립니다. 문의드릴 내용은 다음의 3가지입니다.
1) CCP 설비에서 전극에 RF Power을 인가하면, 이온과 전자의 모빌리티 차이로 인해 이온과 전자가 다른 거동을 보이고 각각의 Flux가 Saturation 될 때 전극 표면에는 (-)전하가 쌓이고, 반대로 Bulk Plasma에는 (+)전하가 쌓인다고 이해했습니다.
따라서 이 때 Bulk Plasma의 (+)전위를 Vpp, 전극 표면의 (-)전위를 Vdc로 이해하는 것이 옳은지 궁금합니다. (아래 모식도처럼 된다고 이해했습니다)
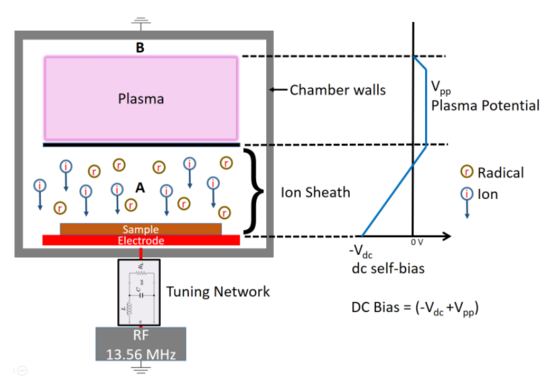
2. CCP 설비에 RF Power를 인가할 때, 조절할 수 있는 Parameter로 Power[W]가 있습니다. Power=Voltage*Current로 나타낼 수 있는데, 이 때의 Voltage가 Vpp를 나타내는 것인지 궁금합니다. 만약 그렇다면 Current는 상기 모식도에서 어떻게 흐른다고 이해하면 되는지 궁금합니다.
3. 현재 현업에서 Vpp, Vdc, Matcher의 Load, Tune Capacitor Position 값이 이전 대비 변화할 경우, RF Generator, Matcher, Chamber 내 환경이 변화하였다고 판단합니다.
그 근거는 상기 Parameter는 결국 사용자가 조작하는 값이 아닌, Plasma 거동에 따라 변화하는 값이므로 상기 Parameter가 변화하였다고 Plasma 거동 변화에 대해 구체적으로 알기는 어렵다고 생각했습니다. 다만 RF Generator나 Matcher, Chamber 내 환경이 변하면 Plasma 거동이 바뀌므로 상기 Parameter가 변함에 따라 RF Generator, Matcher, Chamber 내 환경이 변했다고 추론만 할 수 있다고 봤습니다.
이러한 판단이 적절한지, 혹은 다른 접근방법이 있는지 궁금합니다.
긴 글 읽어주심에 감사드리며, 가능하시다면 답변 부탁드립니다. 유익한 홈페이지 운영해주심에 감사드립니다.
댓글 1
| 번호 | 제목 | 조회 수 |
|---|---|---|
| 공지 | [필독] QnA 글 작성을 위한 권한 안내 [275] | 76840 |
| 공지 | Q&A 검색 길잡이 – 내게 필요한 정보를 더 빠르게 찾는 방법 | 20252 |
| 공지 | 개인정보 노출 주의 부탁드립니다. | 57192 |
| 공지 | kr 입자 조사에 의한 Cu 스퍼터링 에너지 및 이탈 속도 분포 함수 | 68743 |
| 공지 | 질문하실 때 실명을 사용하여주세요. [3] | 92585 |
| 796 | Druyvesteyn Distribution | 5 |
| 795 | C2H2 플라즈마코팅시 가스 원인과 대책 | 6 |
| 794 |
Showerhead와 Heater간 간격에 따른 RPC 효율성
[1] | 14 |
| 793 | DBD 방전 방식의 저온 플라즈마 관련해서 3가지 질문 드립니다. [1] | 15 |
| 792 | 플라즈마 식각 커스핑 식각량 | 16 |
| 791 | 새삼스럽지만 챔버 내에 전류의 정의를 여쭤보고싶습니다. [1] | 47 |
| 790 | 진공 챔버에서 Plasma Off시 Particle의 wafer 표면 충돌 속도 [1] | 53 |
| 789 | 플라즈마 설비에 대한 질문 | 59 |
| 788 | 내플라즈마 코팅의 절연손실에 따른 챔버 내부 분위기 영향 여부 질문드립니다. [1] | 61 |
| 787 | 자성 물질 Etching 시 Process Parameter 질문 [1] | 67 |
| 786 | Ni DC 스퍼터 관련 질문있습니다. [1] | 68 |
| 785 | 스미스차트의 저항계수에 대한 질문드립니다 | 76 |
| 784 | RF magnetron Sputtering 공정에서의 질문 [1] | 78 |
| 783 | RF 반사와 전기에서 쓰이는 무효전력 반사 차이점이 궁금합니다. [1] | 88 |
| 782 | 반사파에 의한 micro arc 질문 [2] | 107 |
| 781 | RF generator의 AMP 종류 질문입니다. [1] | 111 |
| 780 | Impedance I 값을 결정 짓는 요소 관련 질문 [1] | 113 |
| 779 | Microwave & RF Plasma [1] | 130 |
| 778 | sputtering 을 이용한 film depostion [1] | 131 |
| 777 | 챔버 내 전자&이온의 에너지 손실에 대해 [1] | 132 |
