kr 입자 조사에 의한 Cu 스퍼터링 에너지 및 이탈 속도 분포 함수
2009.11.17 16:06
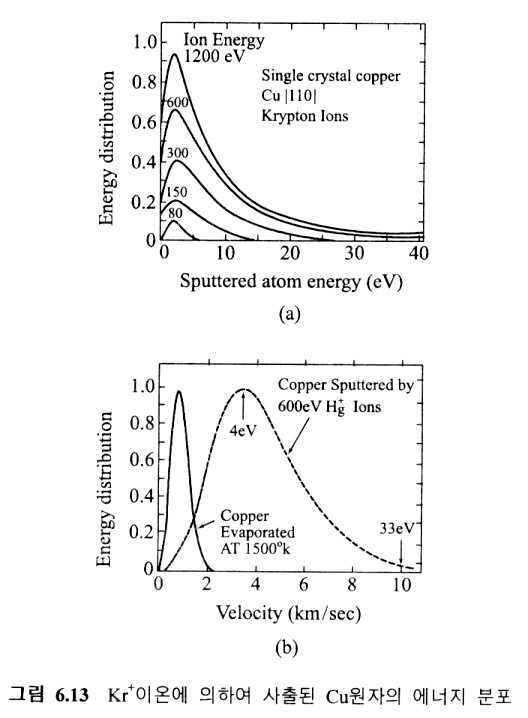
안녕하세요. 전남대학교 정세훈이라고 합니다.
몇가지 궁금한점이 있어 질문드립니다
a) the typical energy of sputtered Cu atoms if the Ar ion has an energy of 500 eV.
b) the typical energy of sputtered Cu atoms if the Ar ion has an energy of 5000 eV
Cu원자의 에너지값이 어떻게되나요? 여러논문을 검색해보았는데
thompson distribution E/(E+Eb) 에 대해서는 나오는데.. 계산이 잘 안돼서요..
--------------------
위의 질문에 대한 참고 자료를 군산대학교 주정훈교수님께서 올려 주셨습니다. 그림과 같이 Kr 입자 조사에 의한 스퍼터링된 Cu의 에너지 및 이탈 속도 함수를 보여주고 있습니다. Ar과 조사 입자의 질량 차이가 있을 뿐 이를 고려한다면 거의 현상은 유사할 것으로 판단됩니다. 이 자료는 교재에 있다고 하니 참고하시기 바랍니다.
